功率MOSFET基础
内容表
1.基本器件结构
2.击穿电压
3.导通状态特性
4.电容
5.栅极电荷
6.栅极电阻
7.导通和关断
8.体二极管正向电压
9.体二极管反向恢复
10.雪崩能力和额定
11.dV/dt额定
12.热阻特性
13.功率耗散
14.安全工作区
15.电流额定
1.基本器件结构
功率MOSFET (金属氧化物半导体场效应晶体管)是非常通用的功率器件,因为它具有低的栅极驱动功率,快的开关速度和优异的并联工作能力。许多功率MOSFET具有纵向的垂直结构,源极和漏极在晶元的相对的平面,从而可以流过大的电流和具有高的电压。
图1a和1b示出沟漕和平面两种基本的器件结构。沟漕结构主要用于额定电压低于200V的器件,因为它具有高的沟道密度,因此导通电阻低。平面结构适合于更高的额定电压器件,因为导通电阻主要由epi-层的电阻来决定,因此无法得到高的单元密度。两种结构基本的操作相同。除了特别的定义,本文只讨论沟漕结构。
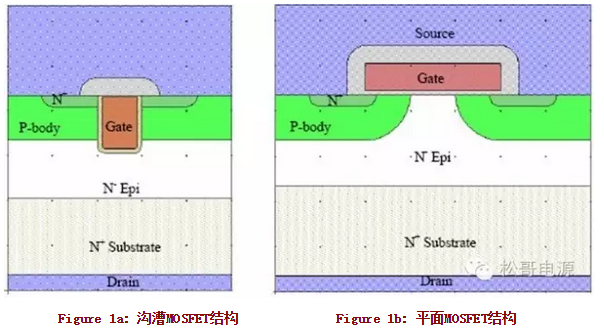
2.击穿电压
在许多功率MOSFET中,N+ 源极和P-体形成的结是通过金属物短路的,从而避免意外的导通寄生的三极管。当没有偏置加在栅极时,功率MOSFET通过反向偏置P-体和N- Epi形成的结,可以承受高的漏极电压。
在高压器件中,绝大部分电压由少掺杂的Epi层来承受:厚的少掺杂的Epi层承受更高的击穿耐压,但是增加了导通电阻。在低压器件中,P-体掺杂程度和N- Epi层差不多,也可以承受电压。如果P-体的厚度不够,重掺杂太多,耗尽区可以通孔达到N+ 源极区,从而降低了击穿电压值。如果P-体的厚度太大,重掺杂不够,沟道的电阻和阈值电压将增大。因此需要仔细的设计体和Epi掺杂和厚度以优化其性能。
数据表中,BVDSS通常定义为漏电流为250uA时漏极到源极的电压。漏极到源极的漏电流表示为IDSS,它在100%的BVDSS额定时测量。温度增加,IDSS增加,BVDSS也增加。
3.导通状态特性
要考虑功率MOSFET在两种不同的模式下工作:第一象限和第三象限工作。
第一象限工作
当正向电压加在漏极上时,N沟道的功率MOSFET操作在第一象限工作,如图2所示。当栅极电压VG增加到阈值电压VTH时,MOSFET沟道开始流过电流。它流过电流的值取决于MOSFET的导通电阻,定义为:
RDSON=VD/ID
对于足够的栅极电荷过驱动VG>>VTH,ID-VD曲线操作在线性区,因为MOSFET的沟道完全导通。在低的栅极过驱动电压下,当VD>(VG-VTH),由于沟道的修剪效应,漏极电流达到饱和点。
对于沟漕MOSFET, RDSON由于下面几个部分组成:
- RS: 源极电阻
- RCH: 沟道电阻
- RACC: 聚集区电阻
- REPI: 硅片顶层电阻,外延硅,有名epi;epi控制着MOSFET可以承受阻断电压值
- RSUBS: 硅衬底电阻,epi从它上面生长。
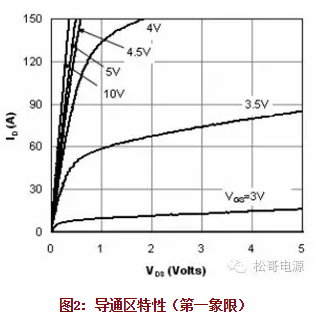
对于沟漕MOSFET, RDSON由于下面几个部分组成:
Copyright © 2013 深圳市奥伟斯科技有限公司版权所有 All Right Reserved ICP备:粤ICP备12049165号